氮?dú)饣亓骱干碳?/h1>
來源:
發(fā)布時(shí)間:2025-06-05
回流焊技巧主要涉及材料選擇、工藝路線確定、設(shè)備操作以及過程監(jiān)控等方面。以下是對(duì)回流焊技巧的詳細(xì)解析:一、材料選擇與準(zhǔn)備焊膏選擇:選擇**機(jī)構(gòu)推薦或經(jīng)過驗(yàn)證的焊膏,確保焊膏的成分、熔點(diǎn)等參數(shù)與焊接要求相匹配。焊膏的存儲(chǔ)和使用應(yīng)遵守相關(guān)規(guī)定,避免污染和變質(zhì)。PCB與元器件:PCB板應(yīng)平整、無變形,表面清潔無油污。元器件應(yīng)正確、牢固地貼裝在PCB上,避免移位或掉落。二、工藝路線確定溫度曲線設(shè)置:根據(jù)焊膏的熔點(diǎn)和元器件的耐熱性,合理設(shè)置預(yù)熱區(qū)、保溫區(qū)、回流區(qū)和冷卻區(qū)的溫度。預(yù)熱區(qū)溫度應(yīng)逐漸升高,避免溫度突變導(dǎo)致PCB變形或元器件損壞。保溫區(qū)溫度應(yīng)保持穩(wěn)定,確保焊膏中的助焊劑充分活化。回流區(qū)溫度應(yīng)達(dá)到焊膏的熔點(diǎn),使焊膏完全熔化并形成焊點(diǎn)。冷卻區(qū)溫度應(yīng)逐漸降低,避免焊點(diǎn)產(chǎn)生裂紋或應(yīng)力。傳送帶速度:傳送帶速度應(yīng)根據(jù)PCB的尺寸、元器件的密度和溫度曲線的設(shè)置進(jìn)行調(diào)整。速度過快可能導(dǎo)致焊點(diǎn)加熱不足,速度過慢則可能導(dǎo)致PCB過度加熱而變形。
回流焊技術(shù),自動(dòng)化生產(chǎn),保障焊接質(zhì)量,提升產(chǎn)品競(jìng)爭(zhēng)力。氮?dú)饣亓骱干碳?/p>

回流焊溫度對(duì)電路板的影響主要體現(xiàn)在以下幾個(gè)方面:一、焊點(diǎn)質(zhì)量熔化狀態(tài):回流焊過程中,溫度是決定錫膏熔化狀態(tài)的關(guān)鍵因素。若溫度過低,錫膏無法完全熔化,會(huì)產(chǎn)生冷焊現(xiàn)象,導(dǎo)致焊點(diǎn)外觀粗糙、內(nèi)部結(jié)構(gòu)疏松,焊點(diǎn)強(qiáng)度不足,容易在后續(xù)使用過程中出現(xiàn)開路故障。反之,溫度過高則可能使焊料過度氧化,同樣會(huì)降低焊點(diǎn)的可靠性。潤(rùn)濕效果:合適的溫度有助于錫膏在焊盤和元器件引腳間形成良好的潤(rùn)濕效果,從而確保焊接的牢固性和可靠性。溫度過低或過高都可能影響潤(rùn)濕效果,進(jìn)而影響焊接質(zhì)量。二、電路板材料性能基材變形:常用的電路板基材如FR-4,在高溫下會(huì)經(jīng)歷玻璃化轉(zhuǎn)變。若回流焊溫度過高,接近或超過基材的玻璃化轉(zhuǎn)變溫度,基材會(huì)變軟、變形。這尤其在精密電路板如醫(yī)療設(shè)備電路板中需特別留意,因?yàn)榛淖冃螘?huì)影響元器件間距和電氣性能。布線影響:電路板上的布線在溫度變化時(shí)會(huì)產(chǎn)生熱膨脹。若回流焊溫度控制不當(dāng),可能導(dǎo)致布線斷裂或短路,特別是細(xì)間距布線風(fēng)險(xiǎn)更高。
bomp回流焊注意事項(xiàng)回流焊技術(shù),快速加熱,精確焊接,確保電子產(chǎn)品可靠性。

Heller回流焊在半導(dǎo)體行業(yè)中的應(yīng)用非常寬泛,能夠滿足高精度、高穩(wěn)定性和高效率的封裝要求。技術(shù)特點(diǎn)與優(yōu)勢(shì)高精度:Heller回流焊設(shè)備具有高精度的特點(diǎn),能夠滿足半導(dǎo)體封裝中對(duì)焊接位置、焊接溫度和焊接時(shí)間的精確控制要求。高穩(wěn)定性:Heller回流焊設(shè)備能夠保持穩(wěn)定的溫度和時(shí)間控制,確保焊接質(zhì)量的穩(wěn)定性,減少焊接過程中的不良率和返工率。高效率:Heller回流焊設(shè)備能夠快速完成焊接過程,提高生產(chǎn)效率,滿足半導(dǎo)體行業(yè)對(duì)高產(chǎn)量的需求。低空洞率:Heller的真空回流焊技術(shù)能夠有效降低焊接過程中的空洞率,提高封裝結(jié)構(gòu)的可靠性和穩(wěn)定性。四、適用設(shè)備型號(hào)Heller在半導(dǎo)體行業(yè)中推出了多款適用于不同應(yīng)用場(chǎng)景的回流焊設(shè)備,如1911MK5-VR單軌在線真空回流焊爐和1809MK5VR真空回流焊等。這些設(shè)備具有多溫區(qū)設(shè)計(jì)、高效無油真空泵機(jī)組、高效助焊劑回收系統(tǒng)等先進(jìn)技術(shù)特點(diǎn),能夠滿足半導(dǎo)體封裝中的各種復(fù)雜需求。
Heller的回流焊機(jī)解決方案在電子制造行業(yè)中享有盛譽(yù),以其高精度、高穩(wěn)定性和高效率而著稱。以下是對(duì)Heller回流焊機(jī)解決方案的詳細(xì)介紹:一、重心特點(diǎn)高精度傳送:Heller回流焊機(jī)采用先進(jìn)的導(dǎo)螺桿設(shè)計(jì),確保了嚴(yán)格的公差和平行度。即使在邊緣間距較小的板上,也能保持高精度的傳送,從而提高生產(chǎn)線上的加工準(zhǔn)確性和穩(wěn)定性。高效冷卻:新設(shè)計(jì)的吹氣冷卻模塊使得Heller回流焊機(jī)具備超快速的冷卻能力。冷卻速率可達(dá)每秒3°C以上,甚至更高,這對(duì)于LGA775等熱敏感元件的焊接尤為重要。同時(shí),雙風(fēng)扇和平面線圈冷卻技術(shù)進(jìn)一步增強(qiáng)了散熱性能。智能化與網(wǎng)絡(luò)化:Heller回流焊機(jī)通過信息物理融合系統(tǒng),實(shí)現(xiàn)了智能工廠、智能設(shè)備和網(wǎng)絡(luò)化系統(tǒng)的運(yùn)用。這極大提高了生產(chǎn)線的效率,并為企業(yè)帶來更多商機(jī)。同時(shí),Heller提供相應(yīng)的電腦主機(jī)/loM接口,包括**控制系統(tǒng)、產(chǎn)品數(shù)據(jù)管理等功能,有力地支持了整個(gè)工業(yè)控制。能源管理:配備強(qiáng)大的能源管理和控制系統(tǒng),用戶可以根據(jù)需要對(duì)加熱區(qū)域進(jìn)行靈活調(diào)整,以便節(jié)省成本并滿足環(huán)保要求。
回流焊:通過熱氣流熔化焊錫,完成電子元件與PCB的電氣連接。
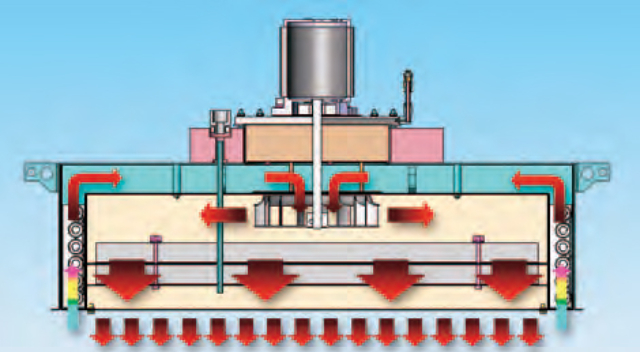
回流焊作為一種電子制造行業(yè)中寬泛應(yīng)用的焊接方法,具有明顯的優(yōu)點(diǎn),同時(shí)也存在一些缺點(diǎn)。以下是對(duì)回流焊優(yōu)缺點(diǎn)的詳細(xì)分析:優(yōu)點(diǎn)高生產(chǎn)效率:回流焊是一種自動(dòng)化生產(chǎn)工藝,能夠大幅提高生產(chǎn)效率,特別適用于大批量、高密度的電子產(chǎn)品生產(chǎn)。高焊接質(zhì)量:回流焊具有良好的溫度控制和熱循環(huán)特性,有助于提高焊接質(zhì)量,減少焊接缺陷,如虛焊、熱疲勞、錫瘤等。適用范圍廣:回流焊適用于各種尺寸和形狀的電子元件,包括貼片元件、插件元件等,具有寬泛的適用性。節(jié)省材料:回流焊過程中錫膏的使用量較少,有助于降低生產(chǎn)成本。環(huán)保:回流焊采用無鉛錫膏,符合環(huán)保要求,減少了對(duì)環(huán)境的影響。穩(wěn)定性和兼容性:回流焊技術(shù)在進(jìn)行焊接時(shí),采用局部加熱的方式完成焊接任務(wù),被焊接的元器件受到的熱沖擊小,不會(huì)過熱造成元器件的損壞。焊料純凈:回流焊中焊料是一次性使用的,焊料純凈無雜質(zhì),保證了焊點(diǎn)的質(zhì)量。缺點(diǎn)對(duì)設(shè)備要求較高:回流焊所需的加熱設(shè)備、溫度控制系統(tǒng)以及自動(dòng)化生產(chǎn)線的設(shè)備要求較高,初期投資較大,對(duì)于資金有限的企業(yè)來說可能是一個(gè)挑戰(zhàn)。對(duì)材料要求嚴(yán)格:回流焊過程中使用的錫膏、助焊劑以及印刷電路板材料需要具備良好的性能和穩(wěn)定性。若材料不合格。
高效回流焊,自動(dòng)化生產(chǎn),保障焊接精度,提升電子產(chǎn)品性能。氮?dú)饣亓骱干碳?/a>
高效精確的回流焊工藝,保障電子產(chǎn)品焊接質(zhì)量,提升生產(chǎn)自動(dòng)化水平。氮?dú)饣亓骱干碳?/p>
Heller回流焊在半導(dǎo)體行業(yè)的應(yīng)用非常寬泛,主要體現(xiàn)在以下幾個(gè)方面:一、半導(dǎo)體先進(jìn)封裝Heller回流焊在半導(dǎo)體先進(jìn)封裝中發(fā)揮著關(guān)鍵作用。它能夠滿足晶圓級(jí)或面板級(jí)半導(dǎo)體封裝的高精度、高穩(wěn)定性和高效率要求。通過精確的溫度控制和穩(wěn)定的焊接效果,Heller回流焊能夠確保半導(dǎo)體封裝中的電子元件實(shí)現(xiàn)可靠連接,從而提高產(chǎn)品的質(zhì)量和性能。二、具體應(yīng)用場(chǎng)景植球(Bumping)和芯片粘接(DieAttach):這兩個(gè)步驟是晶圓級(jí)或面板級(jí)半導(dǎo)體先進(jìn)封裝的基本步驟。Heller回流焊能夠提供穩(wěn)定的回流工藝,確保焊料熔化并重新凝固,從而實(shí)現(xiàn)電子元件的可靠連接。底部填充固化(Underfill):在半導(dǎo)體封裝中,底部填充固化是確保封裝結(jié)構(gòu)穩(wěn)定性和可靠性的重要步驟。Heller提供多種類型的固化爐,適用于設(shè)備級(jí)和板級(jí)底部填充固化,具有潔凈室等級(jí)和全自動(dòng)化選項(xiàng),適用于大批量生產(chǎn)。蓋子粘接(LidAttach)和球粘接(BallAttach):這兩個(gè)步驟通常涉及與熱界面材料連接的半導(dǎo)體蓋的無空洞焊接。Heller為此提供壓力固化爐(PCO)、壓力回流焊爐(PRO)和甲酸回流焊爐等解決方案,具有經(jīng)過驗(yàn)證的空洞消除功能,確保焊接質(zhì)量。
氮?dú)饣亓骱干碳?/p>
下一篇:
真空ICT技術(shù)規(guī)范
回流焊技巧主要涉及材料選擇、工藝路線確定、設(shè)備操作以及過程監(jiān)控等方面。以下是對(duì)回流焊技巧的詳細(xì)解析:一、材料選擇與準(zhǔn)備焊膏選擇:選擇**機(jī)構(gòu)推薦或經(jīng)過驗(yàn)證的焊膏,確保焊膏的成分、熔點(diǎn)等參數(shù)與焊接要求相匹配。焊膏的存儲(chǔ)和使用應(yīng)遵守相關(guān)規(guī)定,避免污染和變質(zhì)。PCB與元器件:PCB板應(yīng)平整、無變形,表面清潔無油污。元器件應(yīng)正確、牢固地貼裝在PCB上,避免移位或掉落。二、工藝路線確定溫度曲線設(shè)置:根據(jù)焊膏的熔點(diǎn)和元器件的耐熱性,合理設(shè)置預(yù)熱區(qū)、保溫區(qū)、回流區(qū)和冷卻區(qū)的溫度。預(yù)熱區(qū)溫度應(yīng)逐漸升高,避免溫度突變導(dǎo)致PCB變形或元器件損壞。保溫區(qū)溫度應(yīng)保持穩(wěn)定,確保焊膏中的助焊劑充分活化。回流區(qū)溫度應(yīng)達(dá)到焊膏的熔點(diǎn),使焊膏完全熔化并形成焊點(diǎn)。冷卻區(qū)溫度應(yīng)逐漸降低,避免焊點(diǎn)產(chǎn)生裂紋或應(yīng)力。傳送帶速度:傳送帶速度應(yīng)根據(jù)PCB的尺寸、元器件的密度和溫度曲線的設(shè)置進(jìn)行調(diào)整。速度過快可能導(dǎo)致焊點(diǎn)加熱不足,速度過慢則可能導(dǎo)致PCB過度加熱而變形。 回流焊技術(shù),自動(dòng)化生產(chǎn),保障焊接質(zhì)量,提升產(chǎn)品競(jìng)爭(zhēng)力。氮?dú)饣亓骱干碳?/p>

回流焊溫度對(duì)電路板的影響主要體現(xiàn)在以下幾個(gè)方面:一、焊點(diǎn)質(zhì)量熔化狀態(tài):回流焊過程中,溫度是決定錫膏熔化狀態(tài)的關(guān)鍵因素。若溫度過低,錫膏無法完全熔化,會(huì)產(chǎn)生冷焊現(xiàn)象,導(dǎo)致焊點(diǎn)外觀粗糙、內(nèi)部結(jié)構(gòu)疏松,焊點(diǎn)強(qiáng)度不足,容易在后續(xù)使用過程中出現(xiàn)開路故障。反之,溫度過高則可能使焊料過度氧化,同樣會(huì)降低焊點(diǎn)的可靠性。潤(rùn)濕效果:合適的溫度有助于錫膏在焊盤和元器件引腳間形成良好的潤(rùn)濕效果,從而確保焊接的牢固性和可靠性。溫度過低或過高都可能影響潤(rùn)濕效果,進(jìn)而影響焊接質(zhì)量。二、電路板材料性能基材變形:常用的電路板基材如FR-4,在高溫下會(huì)經(jīng)歷玻璃化轉(zhuǎn)變。若回流焊溫度過高,接近或超過基材的玻璃化轉(zhuǎn)變溫度,基材會(huì)變軟、變形。這尤其在精密電路板如醫(yī)療設(shè)備電路板中需特別留意,因?yàn)榛淖冃螘?huì)影響元器件間距和電氣性能。布線影響:電路板上的布線在溫度變化時(shí)會(huì)產(chǎn)生熱膨脹。若回流焊溫度控制不當(dāng),可能導(dǎo)致布線斷裂或短路,特別是細(xì)間距布線風(fēng)險(xiǎn)更高。 bomp回流焊注意事項(xiàng)回流焊技術(shù),快速加熱,精確焊接,確保電子產(chǎn)品可靠性。

Heller回流焊在半導(dǎo)體行業(yè)中的應(yīng)用非常寬泛,能夠滿足高精度、高穩(wěn)定性和高效率的封裝要求。技術(shù)特點(diǎn)與優(yōu)勢(shì)高精度:Heller回流焊設(shè)備具有高精度的特點(diǎn),能夠滿足半導(dǎo)體封裝中對(duì)焊接位置、焊接溫度和焊接時(shí)間的精確控制要求。高穩(wěn)定性:Heller回流焊設(shè)備能夠保持穩(wěn)定的溫度和時(shí)間控制,確保焊接質(zhì)量的穩(wěn)定性,減少焊接過程中的不良率和返工率。高效率:Heller回流焊設(shè)備能夠快速完成焊接過程,提高生產(chǎn)效率,滿足半導(dǎo)體行業(yè)對(duì)高產(chǎn)量的需求。低空洞率:Heller的真空回流焊技術(shù)能夠有效降低焊接過程中的空洞率,提高封裝結(jié)構(gòu)的可靠性和穩(wěn)定性。四、適用設(shè)備型號(hào)Heller在半導(dǎo)體行業(yè)中推出了多款適用于不同應(yīng)用場(chǎng)景的回流焊設(shè)備,如1911MK5-VR單軌在線真空回流焊爐和1809MK5VR真空回流焊等。這些設(shè)備具有多溫區(qū)設(shè)計(jì)、高效無油真空泵機(jī)組、高效助焊劑回收系統(tǒng)等先進(jìn)技術(shù)特點(diǎn),能夠滿足半導(dǎo)體封裝中的各種復(fù)雜需求。
Heller的回流焊機(jī)解決方案在電子制造行業(yè)中享有盛譽(yù),以其高精度、高穩(wěn)定性和高效率而著稱。以下是對(duì)Heller回流焊機(jī)解決方案的詳細(xì)介紹:一、重心特點(diǎn)高精度傳送:Heller回流焊機(jī)采用先進(jìn)的導(dǎo)螺桿設(shè)計(jì),確保了嚴(yán)格的公差和平行度。即使在邊緣間距較小的板上,也能保持高精度的傳送,從而提高生產(chǎn)線上的加工準(zhǔn)確性和穩(wěn)定性。高效冷卻:新設(shè)計(jì)的吹氣冷卻模塊使得Heller回流焊機(jī)具備超快速的冷卻能力。冷卻速率可達(dá)每秒3°C以上,甚至更高,這對(duì)于LGA775等熱敏感元件的焊接尤為重要。同時(shí),雙風(fēng)扇和平面線圈冷卻技術(shù)進(jìn)一步增強(qiáng)了散熱性能。智能化與網(wǎng)絡(luò)化:Heller回流焊機(jī)通過信息物理融合系統(tǒng),實(shí)現(xiàn)了智能工廠、智能設(shè)備和網(wǎng)絡(luò)化系統(tǒng)的運(yùn)用。這極大提高了生產(chǎn)線的效率,并為企業(yè)帶來更多商機(jī)。同時(shí),Heller提供相應(yīng)的電腦主機(jī)/loM接口,包括**控制系統(tǒng)、產(chǎn)品數(shù)據(jù)管理等功能,有力地支持了整個(gè)工業(yè)控制。能源管理:配備強(qiáng)大的能源管理和控制系統(tǒng),用戶可以根據(jù)需要對(duì)加熱區(qū)域進(jìn)行靈活調(diào)整,以便節(jié)省成本并滿足環(huán)保要求。 回流焊:通過熱氣流熔化焊錫,完成電子元件與PCB的電氣連接。
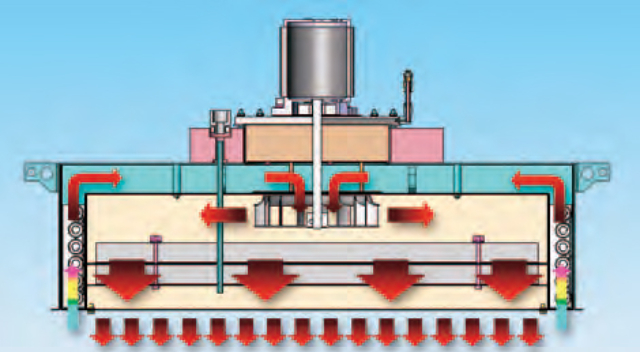
回流焊作為一種電子制造行業(yè)中寬泛應(yīng)用的焊接方法,具有明顯的優(yōu)點(diǎn),同時(shí)也存在一些缺點(diǎn)。以下是對(duì)回流焊優(yōu)缺點(diǎn)的詳細(xì)分析:優(yōu)點(diǎn)高生產(chǎn)效率:回流焊是一種自動(dòng)化生產(chǎn)工藝,能夠大幅提高生產(chǎn)效率,特別適用于大批量、高密度的電子產(chǎn)品生產(chǎn)。高焊接質(zhì)量:回流焊具有良好的溫度控制和熱循環(huán)特性,有助于提高焊接質(zhì)量,減少焊接缺陷,如虛焊、熱疲勞、錫瘤等。適用范圍廣:回流焊適用于各種尺寸和形狀的電子元件,包括貼片元件、插件元件等,具有寬泛的適用性。節(jié)省材料:回流焊過程中錫膏的使用量較少,有助于降低生產(chǎn)成本。環(huán)保:回流焊采用無鉛錫膏,符合環(huán)保要求,減少了對(duì)環(huán)境的影響。穩(wěn)定性和兼容性:回流焊技術(shù)在進(jìn)行焊接時(shí),采用局部加熱的方式完成焊接任務(wù),被焊接的元器件受到的熱沖擊小,不會(huì)過熱造成元器件的損壞。焊料純凈:回流焊中焊料是一次性使用的,焊料純凈無雜質(zhì),保證了焊點(diǎn)的質(zhì)量。缺點(diǎn)對(duì)設(shè)備要求較高:回流焊所需的加熱設(shè)備、溫度控制系統(tǒng)以及自動(dòng)化生產(chǎn)線的設(shè)備要求較高,初期投資較大,對(duì)于資金有限的企業(yè)來說可能是一個(gè)挑戰(zhàn)。對(duì)材料要求嚴(yán)格:回流焊過程中使用的錫膏、助焊劑以及印刷電路板材料需要具備良好的性能和穩(wěn)定性。若材料不合格。 高效回流焊,自動(dòng)化生產(chǎn),保障焊接精度,提升電子產(chǎn)品性能。氮?dú)饣亓骱干碳?/a>
高效精確的回流焊工藝,保障電子產(chǎn)品焊接質(zhì)量,提升生產(chǎn)自動(dòng)化水平。氮?dú)饣亓骱干碳?/p>
Heller回流焊在半導(dǎo)體行業(yè)的應(yīng)用非常寬泛,主要體現(xiàn)在以下幾個(gè)方面:一、半導(dǎo)體先進(jìn)封裝Heller回流焊在半導(dǎo)體先進(jìn)封裝中發(fā)揮著關(guān)鍵作用。它能夠滿足晶圓級(jí)或面板級(jí)半導(dǎo)體封裝的高精度、高穩(wěn)定性和高效率要求。通過精確的溫度控制和穩(wěn)定的焊接效果,Heller回流焊能夠確保半導(dǎo)體封裝中的電子元件實(shí)現(xiàn)可靠連接,從而提高產(chǎn)品的質(zhì)量和性能。二、具體應(yīng)用場(chǎng)景植球(Bumping)和芯片粘接(DieAttach):這兩個(gè)步驟是晶圓級(jí)或面板級(jí)半導(dǎo)體先進(jìn)封裝的基本步驟。Heller回流焊能夠提供穩(wěn)定的回流工藝,確保焊料熔化并重新凝固,從而實(shí)現(xiàn)電子元件的可靠連接。底部填充固化(Underfill):在半導(dǎo)體封裝中,底部填充固化是確保封裝結(jié)構(gòu)穩(wěn)定性和可靠性的重要步驟。Heller提供多種類型的固化爐,適用于設(shè)備級(jí)和板級(jí)底部填充固化,具有潔凈室等級(jí)和全自動(dòng)化選項(xiàng),適用于大批量生產(chǎn)。蓋子粘接(LidAttach)和球粘接(BallAttach):這兩個(gè)步驟通常涉及與熱界面材料連接的半導(dǎo)體蓋的無空洞焊接。Heller為此提供壓力固化爐(PCO)、壓力回流焊爐(PRO)和甲酸回流焊爐等解決方案,具有經(jīng)過驗(yàn)證的空洞消除功能,確保焊接質(zhì)量。 氮?dú)饣亓骱干碳?/p>
- 國(guó)產(chǎn)激光開孔機(jī)技術(shù)規(guī)范 2025-06-10
- 實(shí)驗(yàn)室光譜儀費(fèi)用是多少 2025-06-10
- 全國(guó)bomp回流焊技術(shù)指導(dǎo) 2025-06-10
- 進(jìn)口回流焊性能介紹 2025-06-10
- 載板植球機(jī)常見問題 2025-06-10
- 全國(guó)存儲(chǔ)芯片激光開孔機(jī)生產(chǎn)廠家 2025-06-10
- 顯微拉曼技術(shù)光譜儀品牌 2025-06-10
- 植球激光開孔機(jī)推薦廠家 2025-06-10
- 博通植球機(jī)售后服務(wù) 2025-06-10
- 晶圓回流焊注意事項(xiàng) 2025-06-10
- 寶山區(qū)應(yīng)用耐高溫膠帶 2025-06-10
- 湖州ksd301 2025-06-10
- 重慶57(CN)連接器行業(yè)標(biāo)準(zhǔn) 2025-06-10
- HSMS-270C-TR1G 2025-06-10
- 爆改星空頂安裝教程 2025-06-10
- 江蘇光固化粘結(jié)劑涂液技術(shù) 2025-06-10
- 防靜電ESD二極管批量定制 2025-06-10
- 濟(jì)南醫(yī)療SMT貼片多少錢 2025-06-10
- Weinreich Industriekuehlung 2025-06-10
- 湖南XilinxFPGA開發(fā)板解決方案 2025-06-10